| Product Overview |
| |
| This thin package solution has become available due to significant improvement in substrate and die thinning technology. |
| Package |
Total Thickness |
Package Profile |
Solder Ball Pitch |
| LFBGA |
1.20~1.70mm |
Low Profile |
Fine Solder Ball Pitch |
| TFBGA |
1.00~1.20mm |
Thin Profile |
Fine Solder Ball Pitch |
| VFBGA |
0.80~1.00mm |
Very Thin Profile |
Fine Solder Ball Pitch |
| WFBGA |
0.65~0.80mm |
Very Very Thin Profile |
Fine Solder Ball Pitch |
| UFBGA |
0.50~0.65mm |
Ultra thin Profile |
Fine Solder Ball Pitch |
|
| * Small, thin and light package |
| * Flexible design |
| * Low cost and & time to market high volume production |
| * Competitive reliability performance (MSL3@260°C) |

|
| Application |
| |
| FBGA is commonly used in hand-held devices, like computer, communication, and consumer devices. Increasing demand for thin packages with high density performance make FBGA a highly competitive and reliable package solution to meet this growing demand. This package is highly recommended for Memory (SRAM, PSRAM, Flash, DRAM), Graph, ASIC, Digital and Analog products. |

|
| Features |
| |
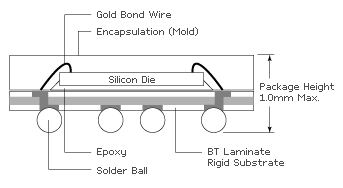 |
| |
| 3x3 mm to 21x21 mm body size available |
| Max 672 I/Os |
| 0.4/0.5/0.65/0.75/0.8/1.0 mm in ball pitch |
| Rigid and customized routing substrate design |
| High density interconnection |
| Full in-house design capability |
| Fine pitch wire bond capability |
| Low assembly cost |
| Self-alignment during re-flow |
| High speed performance |
| Lower profile (Package thickness) |
| RoHS/ Pb Free & Green Package process ready and available |
| Ease of thermal and electrical management |
| Ease of routing |
| JEDEC standard criteria |
|

|
| Reliability |
| |
| MSL3@260°C |
| Test Item |
Reference |
Condition/Duration |
| MSL Level 3 |
JEDEC 22-A103 |
30°C/60% RH, 192 hrs |
| TCT |
JEDEC 22-A104-B |
-65°C to 150°C, 500, 1000 cycles |
| HAST |
JEDEC 22-A118 |
130°C/85% RH, 33.5 PSI, 50/100, hrs |
| HTST |
JEDEC 22-A103-B |
150°C 500/1000 hrs |
| THT |
JEDEC 22-A101-B |
85°C/85%RH 500/1000 hrs |
|

|
| Package Structure |
| |
 |
| ItemThickness (Total) |
Units |
LFBGA |
TFBGA |
VFBGA |
WFBGA |
UFBGA |
| Total Thickness (Max) |
mm |
1.20~1.70 |
1.2 |
1 |
0.8 |
0.65 |
| Mold ThicknessPackage size (A) |
mm |
0.53~0.91 |
0.45~0.70 |
0.45~0.53 |
0.30~0.45 |
0.25~0.3 |
| Substrate thickness (B) |
mm |
0.21~0.56 |
0.21~0.36 |
0.21~0.26 |
0.17~0.21 |
0.13~0.17 |
| Solder ball height (C) |
mm |
0.16~0.46 |
0.16~0.40 |
0.07~0.23 |
0.06~0.21 |
0.02~0.14 |
| Wafer thickness (D) |
um |
125~200 |
125~200 |
100~150 |
75~100 |
50~75 |
| Max Epoxy (E) |
um |
50 |
50 |
38 |
25 |
25 |
| Max Loop height (F) |
um |
200 |
150 |
140 |
125 |
100 |
|

|