| Product Overview |
| |
| Heat slug BGA (HSBGA) is an upgraded type of PBGA. Within the molding area, a piece of copper heat slug is implanted. The heat slug is intended to lower the thermal resistance (θJA) of PBGA without change of material. The θJA of HSBGA is generally 20% lower than PBGA and achieves 5 to 6W of thermal dissipation under natural convection. This technology can be applied to any kind of die-up substrates (e.g. 2- or 4-layer BT, and metal core). HSBGA is an excellent solution for cost-effective high power package, high- speed ICs like graphics chips, communication and networking ICs. |

|
| Application |
| |
| HSBGA is excellent for products that require improved thermal performance such as high power packages for high speed ICs in personal computers, networking and graphic ICs, data communication, consumer ICs and in telecommunication applications. |

|
| Features |
| |
| HSBGA is suitable for high power and high speed ICs requiring superb electrical and thermal enhancement. |
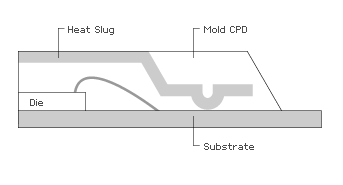 |
| 15x15 mm to 45x45 mm package available |
| 120 balls to 1520 ball count available |
| Cost effective |
| Good electrical performance |
| Good thermal performance |
| Good power dissipation |
| JEDEC MS-034 standard outlines |
| Lead free process ready and available |
| Full In-house design capability |
| Full electrical and thermal characterization capability |
|

|
| Reliability |
| |
| Package Level |
| Test item |
Reference Standard |
Condition/Duration |
| MSL |
JEDEC22-A103 |
Level 3, 30°C/60% RH, 192 hrs |
| TCT |
JEDEC 22-A104-B |
-65°C to 150°C, 1000 cycles |
| HAST |
JEDEC 22-A118 |
130°C/85% RH, 33.5 psi 96 hrs |
| HTST |
JEDEC 22-A103-B |
150°C, 1000 hrs |
|

|
