| IC Feature Size (um) |
0.18 |
0.13 |
0.09 |
0.065 |
0.045 |
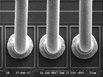 Wire Bond Pad Pitch (um) Wire Bond Pad Pitch (um)
(Single-In-Line) |
60 |
50 |
45 |
40 |
35 |
 Wire Bond Pad Pitch (um) Wire Bond Pad Pitch (um)
(2 Row Staggered) |
80/40 |
70/35 |
60/30 |
50/25 |
40/20 |
 Wire Bond Pad Pitch (um) Wire Bond Pad Pitch (um)
(Tri-Tier) |
90/45 |
80/40 |
70/35 |
60/30 |
50/25 |
 Wire Bond Pad Pitch (um) Wire Bond Pad Pitch (um)
( Quad-Tier ) |
100/50 |
90/45 |
80/40 |
70/30 |
60/30 |
 Wire Bond Pad Pitch (um) Wire Bond Pad Pitch (um)
( 5-Tier ) |
100/50 |
90/45 |
80/40 |
70/30 |
60/30 |
| Package Item |
Available |
2007 |
2008 |
2009 |
| SiP |
SCSP |
Package Thickness (mm)
(2/3/4 die stacked) |
0.5/1.0/1.2 |
0.4/0.8/1.0 |
0.4/0.8/1.0 |
0.4/0.8/1.0 |
| Number of Die |
2/3/4/5/7 |
9 |
9 |
9 |
| Hybrid (WB+FC) |
Eutectic Bump |
Lead free Bump |
Green |
Green |
| PiP |
Package Thickness (mm) |
1.4 |
1.4 |
1.2 |
1.2 |
| Technology |
WB type |
FC+WB type |
FC+WB type |
FC+WB type |
| PoP |
Bottom Package Height (mm) |
1.0 Max |
1.0 Max |
0.9 Max |
0.8 Max |
| PKG Size (mm) |
14X14 |
10X10~20X20 |
10X10~20X20 |
10X10~20X20 |
| Technology |
WB |
FC+WB |
FC+WB |
FC+WB |
| FBGA |
Min. Package Thickness (mm) |
0.5 |
0.4 |
0.4 |
0.4 |
| Max. Package Size (mm) |
27x27 |
21x21 |
21x21 |
21x21 |
| Wire Bond Technology |
Tri-tier |
Tri-tier |
Tri-tier |
Tri-tier |
